随着疫情三年的结束,大家又开始马不停蹄出差、旅游、返乡,生活的压力让人喘不过气。更别提出行的时候,还需要背一个很沉的电脑,以及与它适配的、同样很沉的、形状不规律的、看着就很糟心的电源适配器!
有没有一种东西,能够让大家的出行变得更加轻松(物理上)?
那必须是现在越来越流行的氮化镓(GaN)充电器了!一个氮化镓充电器几乎可以满足所有出行充电的需求,并且占地空间小,简直是出行神器!

图1 氮化镓(GaN)充电器
氮化镓是一种无机物,化学式GaN,是氮和镓的化合物,一种直接能隙(direct bandgap)的半导体材料。GaN材料具有宽禁带、高临界电场强度和高电子饱和速度等特点,其器件耐高温、耐高压、高频和低损耗,大大提升电力器件集成度,简化了电路设计和散热支持,具有重要的价值和广泛的应用,是现在最 火热的第三代半导体材料,没有之一。GaN的应用不止在流行的充电器上,早在2014年日本科学家天野浩就凭借基于GaN材料的蓝光LED获得了诺贝尔奖。
不过GaN就没有缺点了吗?或者说GaN没有改善的地方了吗?
并不是, GaN技术的难点在于晶圆制备工艺。由于制备GaN的单晶材料无法从自然界中直接获取,所以GaN的主要制备方法是在蓝宝石、碳化硅、硅等异质衬底上进行外延。而现在由异质外延生长的GaN普遍存在大量缺陷的问题。缺陷的存在势必会影响到晶体的质量,从而影响到材料和器件的电学性能,最 终影响到未来半导体科技的快速发展。因此,降低GaN晶体里面的缺陷量,提高晶体质量,是当前第三代半导体领域研究很重要的一个课题。
GaN晶体质量/缺陷评估的方法
GaN晶体里面的杂质、缺陷是非常错综复杂的,无法单纯通过某一项缺陷浓度或者杂质含量来定量描述GaN晶体是否是高质量,因此现在评价GaN晶体质量的手段比较有限。根据现有的报道,大致有以下几种:多光子激发光致发光法(Multiphoton-excitation photoluminescence method,简称MPPL)、蚀坑观察法(Etch pit method)以及二次离子质谱(Secondary-ion mass spectrometry,简称SIMS)。
MPPL法
多光子激发光致发光法采用长波长激发,远大于带边荧光波长。激发过程需要同时吸收二个或者多个光子。通过吸收多个脉冲光子,在导带和价带形成电子空穴对,随后非辐射驰豫到导带底和价带顶,最 后产生带边发光和缺陷发光。通过滤波片获得带边和缺陷发光光谱和光强,改变入射光斑的位置,从而得到样品的荧光信号三维分布,即三维成像。多光子荧光三维成像技术可以识别和区分不同类型的位错,但是无法定量评估GaN的晶体质量,而且多光子激发的系统造价高。
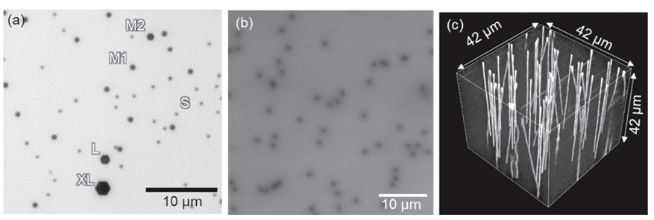
图2 (a) Optical microscope image of etch pits. (b) 42 × 42 μm2 2D MPPL image taken at a depth of 22 μm. (c) 42 × 42 × 42 μm3 3D MPPL image, shown with contrast inverted
参考文献:
Identification of Burgers vectors of threading dislocations in free-standing GaN substrates via multiphoton-excitation photoluminescence mapping' by Mayuko Tsukakoshi et al; Applied Physics Express, Volume 14, Number 5 (2021)
蚀坑观察法
蚀坑观察法通过适当的侵蚀可以看到位错的表面露头,产生比较深的腐蚀坑,借助显微镜可以观察晶体中的位错多少及其分布。该方法只适合于位错密度低的晶体,如果位错密度高,蚀坑互相重叠,就很难将它们区分。并且该方法是对晶体有损伤的,做不到无损无接触。

图3 蚀坑观察法
SIMS技术
SIMS是利用质谱法分辨一次离子入射到测试样品表面溅射生成的二次离子而得到材料表面元素含量及分布的一种方法。SIMS可以进行包括氢在内的全元素分析,并分辨出同位素、化合物组分和部分分子结构的信息。二次离子质谱仪具有ppm量级的灵敏度,最 高甚至达到ppb的量级,还具有进行微区成分成像和深度剖析的功能。但是SIMS对晶体有损伤,无法做到无损。
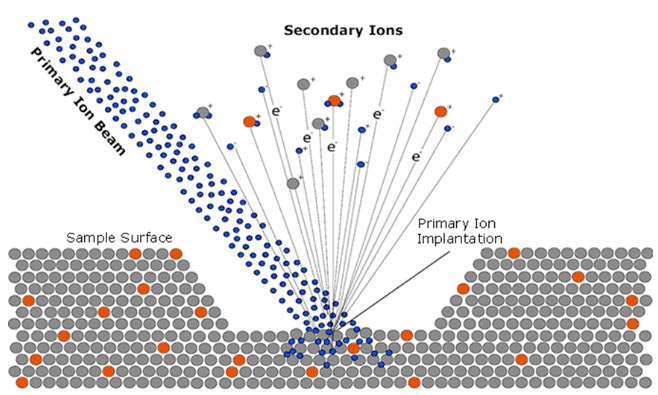
图4 SIMS技术
以上三种技术均是评估GaN晶体缺陷的方法,但是每一种都有其缺憾的地方,它们无法做到定量的去评价GaN晶体的质量,而且具有破坏性。为了更好地定量评估GaN晶体质量,滨松公司和日本Tohoku University的Kazunobu Kojima教授以及Shigefusa Chichibu教授从2016年开始合作研发了一套基于积分球的全向光致发光系统(Omnidirectional Photoluminescence,以下简称ODPL),该系统是第 一个无损无接触定量去评价GaN晶体质量的方法/系统。
ODPL系统
ODPL系统是首 个无接触无损评价半导体材料晶体质量的方法,通过积分球法测量半导体材料、钙钛矿材料的内量子效率。该产品可以直接测量材料 IQE,具有制冷型背照式 CCD 高灵敏度以及高信噪比。

图5 ODPL测量方法示意图
传统光致发光的量子效率测量指的是晶体的PLQY,即光致发光量子效率,其定义为:
PLQY = 样品发射的光子数/样品吸收的光子数

图6 GaN样品在积分球下的发射光谱
PLQY是表征晶体发光效率最 常见的参数之一,对于绝大多数的发光材料,PLQY都是黄金标准。但是对于GaN晶体,PLQY的表征显得不足。上图可见,GaN的光致发射光谱呈双峰形状,这是由于GaN晶体中的缺陷等,会将GaN本身发射的PL再次吸收然后发射(光子回收Photon Recycling现象)。
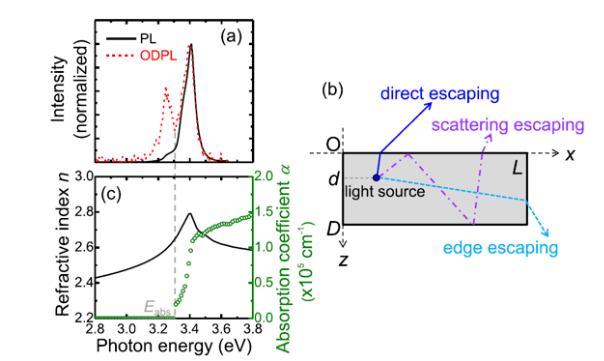
图7 ( a ) PL and ODPL spectra of the HVPE / AT - GaN crystal and ( b ) detectable light - travelling passes considered in the simulation of light extraction :(1) direct escaping from the surface :( ii ) scattered at the bottom and escaping from the surface : and ( ii ) direct eseaping from the edge .( c ) Refractive index and absorption spectra of HVPE / AT - GaN .
因为存在Photon Recycling的现象,GaN的PLQY不足以表征其发光转化效率,而真正可以表征GaN晶体发光转化效率的定义是其真正的内量子效率:
IQE = 样品产生的光子数/样品吸收的光子数
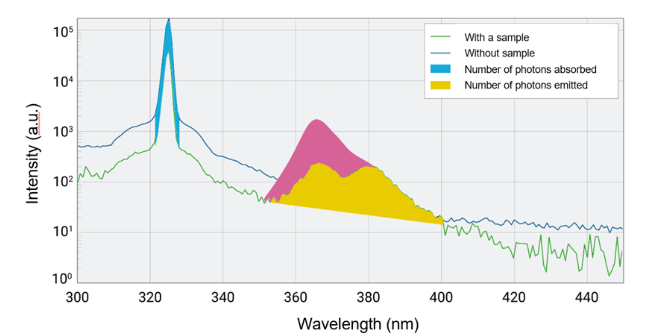
图8 GaN样品的标准发射光谱
IQE是GaN晶体的PLQY考虑LEE和光子回收现象以后的参数,更能直观、定量反映GaN晶体的质量。
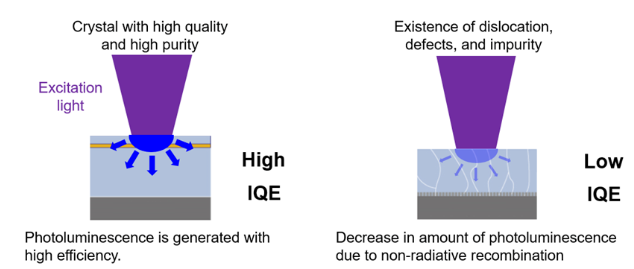
图9 高IQE和低IQE晶体的对比
高IQE的GaN晶体通常表现为:高载流子浓度、低穿透位错密度、低杂质浓度、低点缺陷浓度、高激发功率密度。

图10 不同穿透位错密度晶体的IQE结果对比
免费样机预约ODPL
现在ODPL样机开放免费预约试 用活动,有意向的客户请在评论区留言“样机试 用”小编看到之后会第 一时间与您联系,样机数量有限,先到先得哟~

图11 ODPL样机展示
以上有关新品的信息已经全部介绍完毕了,如有任何疑问,欢迎在评论区留言哟。

 重点解读!精细化工反应安全风险评估规范 GB/T 42300-2022正式发
重点解读!精细化工反应安全风险评估规范 GB/T 42300-2022正式发
 Gene-π数字PCR学堂: 在核酸定量中数字PCR方法学转换及应用(杭州站
Gene-π数字PCR学堂: 在核酸定量中数字PCR方法学转换及应用(杭州站

 评论
评论