半导体探索和开发
先进的电子显微镜、聚焦离子束和相关半导体分析技术可用于识别制造高性能半导体器件的可行解决方案和设计方法。
企业性质生产商
入驻年限第2年
产品介绍:
Thermo Scientific Hyperion II 系统可带来快速、准确的晶体管探测电性表征和故障定位功能,为半导体技术发展、良率提升以及器件可靠性的改善提供有力的支持。Hyperion II 系统卓 越的稳定性可将纳米探测带入低至 5 nm 及以下的技术节点。
Hyperion II 系统的 SPM 技术支持 PicoCurrent 成像,该技术可快速识别短路、开路、漏电路径和电阻触点,其灵敏度比被动式电压对比度高 1,000 倍以上。扫描电容显微镜检查 (SCM) 模块提供基于图像的绝缘体上硅 (SOI) 晶片故障定位,以及高分辨率掺杂剂谱图分析。
功能
| 测量模式 Hyperion II 系统的先进测量模式包括:
|

PicoCurrent 图像(左)指示可疑晶体管,而 I-V 曲线(右)验证异常电性。
电流-电压 (I-V) 测量
探测目标区域内的多个晶体管以定位故障是一项耗时的工作。Hyperion II 系统结合了 I-V 探测的 PicoCurrent 成像功能,可快速找到潜在缺陷,并测量电流-电压曲线,不会引入测量相关偏移。
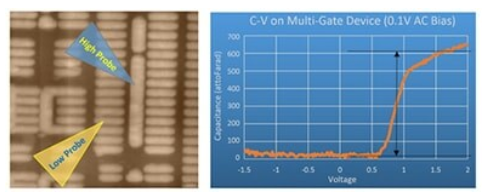
C-V 用于研究氧化物层、界面阱和电荷载体密度。Hyperion II 系统提供高分辨率 C-V,具有出色的阻抗控制、低漏电和极低噪声。
电容电压 (C-V) 测量
C-V 用于研究氧化物层、界面阱和电荷载体密度。Hyperion II 系统提供高分辨率 C-V,具有出色的阻抗控制、低漏电和极低噪声。

脉冲 I-V 用于研究高 k 介质中 SOI 和捕获电荷的自加热。Hyperion II 系统可对器件进行高速测试,上升时间短于 2 纳秒。
脉冲 I-V 测量
脉冲 I-V 用于研究高 k 介质中 SOI 和捕获电荷的自加热。Hyperion II 系统可对器件进行高速测试,上升时间短于 2 纳秒。
主要特点
快速故障定位
集成 PicoCurrent 成像和扫描电容显微镜检查 (SCM) 可快速识别纳米探测的故障候选项。
eFast 指导性操作
半自动分步引导性操作,可提高生产率、易于使用并减轻培训负担。
无电子束-样品相互作用
原子力探针图像和探针特点,无需 SEM 成像和真空系统。
应用
半导体探索和开发
先进的电子显微镜、聚焦离子束和相关半导体分析技术可用于识别制造高性能半导体器件的可行解决方案和设计方法。
半导体故障分析
越来越复杂的半导体器件结构导致更多隐藏故障引起的缺陷的位置。我们的新一代半导体分析工作流程可帮助您定位和表征影响量产、性能和可靠性的细微的电子问题。
物理和化学表征
持续的消费者需求推动了创建更小型、更快和更便宜的电子设备。它们的生产依赖高效的仪器和工作流程,可对多种半导体和显示设备进行电子显微镜成像、分析和表征。
ESD 半导体鉴定
每个静电放电 (ESD) 控制计划都必须识别对 ESD 敏感的器件。我们提供一整套ESD测试系统,帮助满足您的器件鉴定要求。
电源半导体设备分析
电源设备让定位故障面临独特的挑战,主要是由于电源设备结构和布局。我们的电源设备分析工具和工作流程可在工作条件下快速实现故障定位并提供精确、高通量的分析,以便表征材料、接口和设备结构。
